
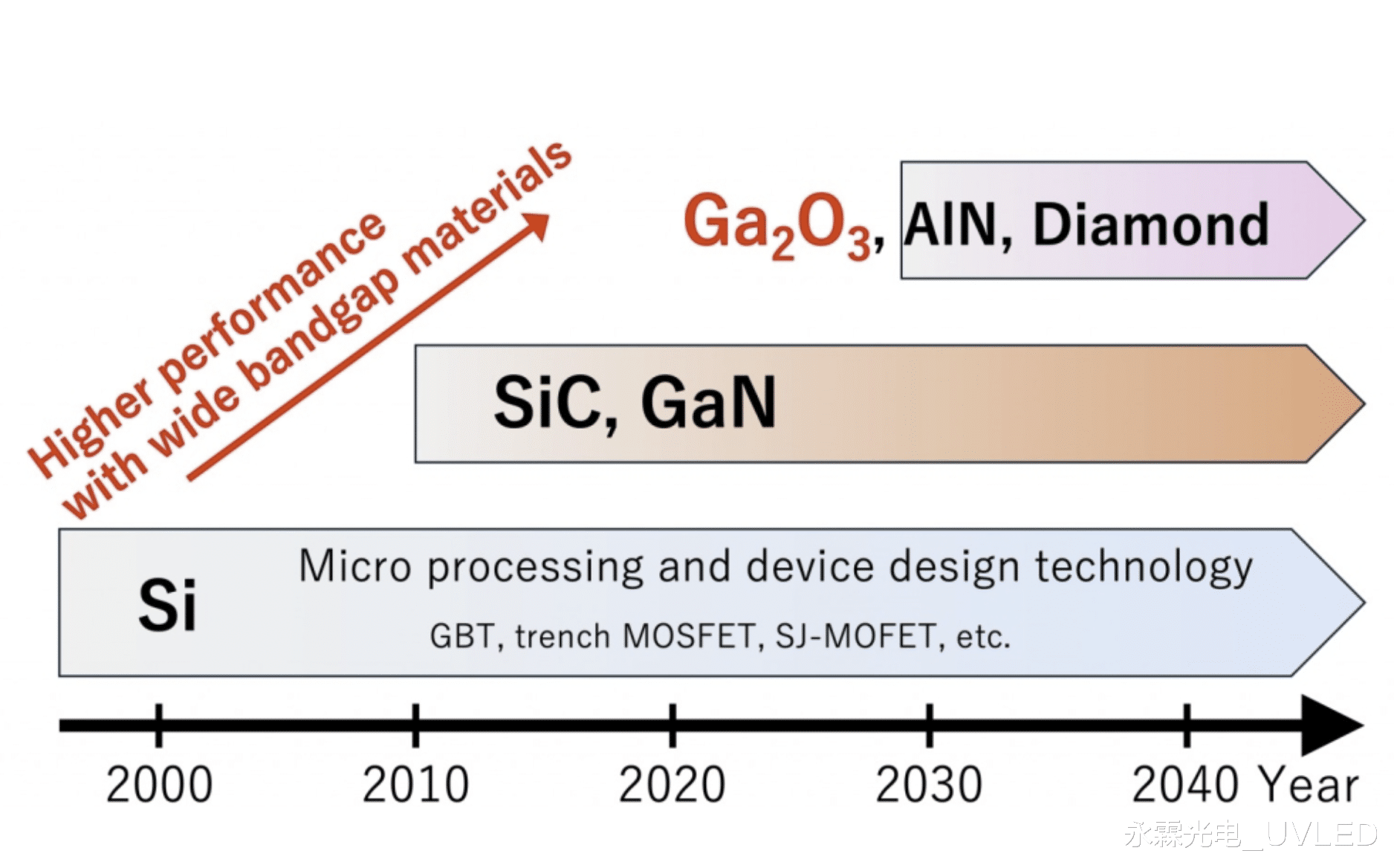
日本研究人员即将宣告六项重大进展,助力氧化镓器件迈向量产新阶段。
日本名古屋大学的研究人员携手大学衍生企业 NU - Rei,在氧化镓(Ga₂O₃)生长技术领域斩获六项突破性进展。这些卓越成果由名古屋大学低温等离子体科学中心的研究小组于日本应用物理学会春季会议(2026 年 3 月 15 - 18 日)上公开发表。
此六项成果协同推进了氧化镓器件量产所需的完整工艺流程栈的构建。其中,一项世界首创的异质外延生长技术尤为瞩目,即于结构相异的基板(硅晶圆)上生长氧化镓晶体层。研究团队指出,这一关键步骤能够大幅降低器件成本,同时显著改善散热性能。
这些成果是在名古屋大学 2025 年 9 月所报道的相关氧化镓 p 型控制进展的基础上进一步拓展而来,并正通过 NU - Rei 公司积极推进商业化进程,旨在推动工业界广泛采用氧化镓生长工艺,以应用于高压、高频以及硅集成器件领域。
这项研究工作的核心在于新研发的高密度氧自由基源(HD - ORS)。相较于传统源,它在薄膜生长期间可使可用的原子氧密度提升一倍。更高的氧密度有力地促进了将亚氧化镓转化为所需 Ga₂O₃ 的化学反应,同时有效抑制了原本会从表面逸出并限制薄膜生长速度的挥发性副产物。该源与分子束外延(MBE)和物理气相沉积(PVD)均具备良好的兼容性。
完整工艺流程栈的进展如下:
HD - ORS 开发新的氧源采用臭氧 - 氧气混合气体,使原子氧密度翻倍,不仅兼容 MBE 和 PVD,更为后续所有生长工作奠定了高效基础。
高速 MBE 同质外延生长借助 HD - ORS,研究团队在掺锡的 Ga₂O₃ 衬底上成功实现了 β - Ga₂O₃ 的同质外延生长。生长温度为 300°C,生长速率达 1µm/小时。通过 X 射线衍射(XRD)和反射高能电子衍射(RHEED),确认了在 (001) 面上的生长情况。较低的生长温度有效减少了热应力,同时拓展了与其他器件组件的兼容性。
高速 PVD 同质外延生长将 HD - ORS 应用于 PVD,在 (001) 取向的同质外延薄膜上实现了超过 1µm/小时的稳定生长速率,近乎传统 MBE 速率的十倍,为工业规模生产指明了方向。
硅衬底预处理为实现在硅上的生长,研究团队确立了一种结合湿化学清洗和在硅表面控制吸附单原子层镓的预处理方法。此方法有效防止了加热过程中的再氧化,经证实对随后的异质外延生长起着至关重要的作用。
硅基上的世界首创异质外延生长研究团队在 2 英寸 Si(100) 晶圆上成功实现了 Ga₂O₃ 的异质外延生长,经热处理确认形成了单晶。硅衬底相较于原生 Ga₂O₃ 衬底……(原文此处未完整,可根据实际情况补充完整后再进行进一步润色)
永霖光电-UVSIS-UVLED紫外线应用专家-独家发布